簡介
制造業(yè)中經(jīng)常提到的“脆性”指的是材料因其獨特的機械特性而歸為的一類。高脆性,即低斷裂抗力,和硬度是材料特性的一種組合,一方面影響著這類材料的應(yīng)用范圍,另一方面也決定了它們的加工性能和可加工性。
脆性的影響因素
影響脆性材料機械行為的因素有幾個:
1. 原子排列: 固體可以是無定形或晶體結(jié)構(gòu)。無定形結(jié)構(gòu)中,原子隨機排列,玻璃、許多塑料和橡膠就是無定形結(jié)構(gòu)的例子。晶體結(jié)構(gòu)則由原子有序排列成規(guī)則的三維晶格,陶瓷可以呈現(xiàn)這兩種結(jié)構(gòu)。
2. 原子鍵類型: 主導原子鍵類型決定了材料傾向于韌性還是脆性行為。共價鍵限制了電子的移動能力,而塑性成型工藝需要大量電子的位置改變,因此大量共價鍵會導致脆性和硬度,而金屬鍵(離子鍵)則導致韌性行為。
應(yīng)用領(lǐng)域
脆性材料憑借其基本特性,在多個領(lǐng)域發(fā)揮著重要作用(圖 1)。
常見脆性材料:
? 高性能陶瓷
? 玻璃
? 玻璃陶瓷
? 石英、藍寶石、CaF2
? 硅、鍺
? CMC(陶瓷基復合材料)
主要特性:
? 低斷裂韌性
? 低斷裂應(yīng)變
? 耐高溫
? 耐化學腐蝕
? 高硬度
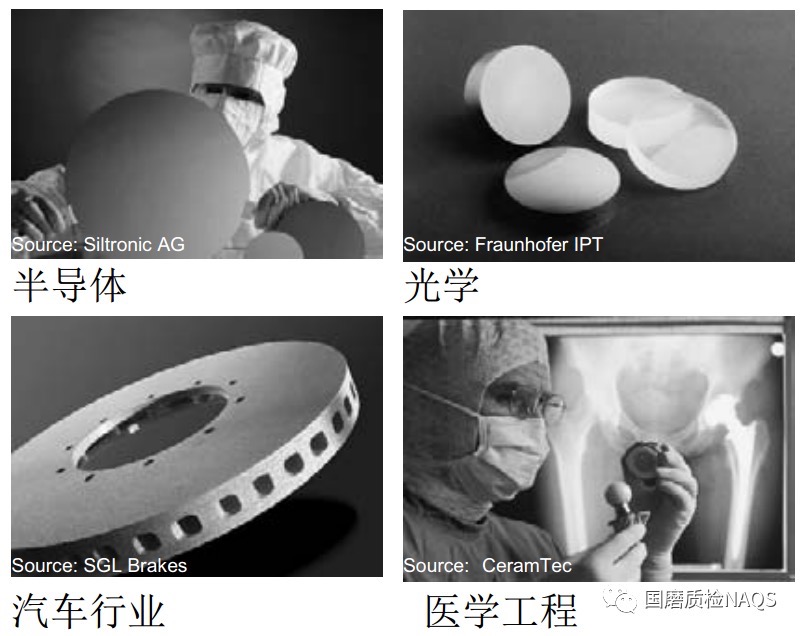
圖1 脆性材料應(yīng)用領(lǐng)域
1 脆性材料的磨削行為
相比于金屬材料,脆性材料的磨削性能由于其獨特的特性而存在很大差異。
與加工韌性材料不同,加工脆性材料時,我們假設(shè)隨著切深增加,材料的破裂成為主導因素,即微裂紋的形成和隨之而來的碎片剝落。
從根本上來說,在局部加載脆性材料(觀察微觀的切屑形成區(qū)域)時,總是存在相同的行為機制 - 裂紋萌生和擴展以及塑性變形。
當?shù)都馍钊氪嘈圆牧蠒r,刀具材料上會形成徑向和橫向裂紋,如圖2 左圖所示。在這種情況下,實際的切屑去除是通過橫向裂紋導致的材料剝落。而軸向裂紋則會導致刀具外表面永久性損傷。這種通常質(zhì)量檢測方法無法發(fā)現(xiàn)的亞表面損傷會導致部件過早失效。
然而,對于脆性材料,也可以實現(xiàn)韌性切屑去除(圖 2 右圖)。要做到這一點,需要減小切屑厚度,使其不超過以下公式指定的臨界值 hcu,krit:

其中,臨界切屑厚度由材料的斷裂韌性 Kc、硬度 H 和彈性模量 E 決定 。
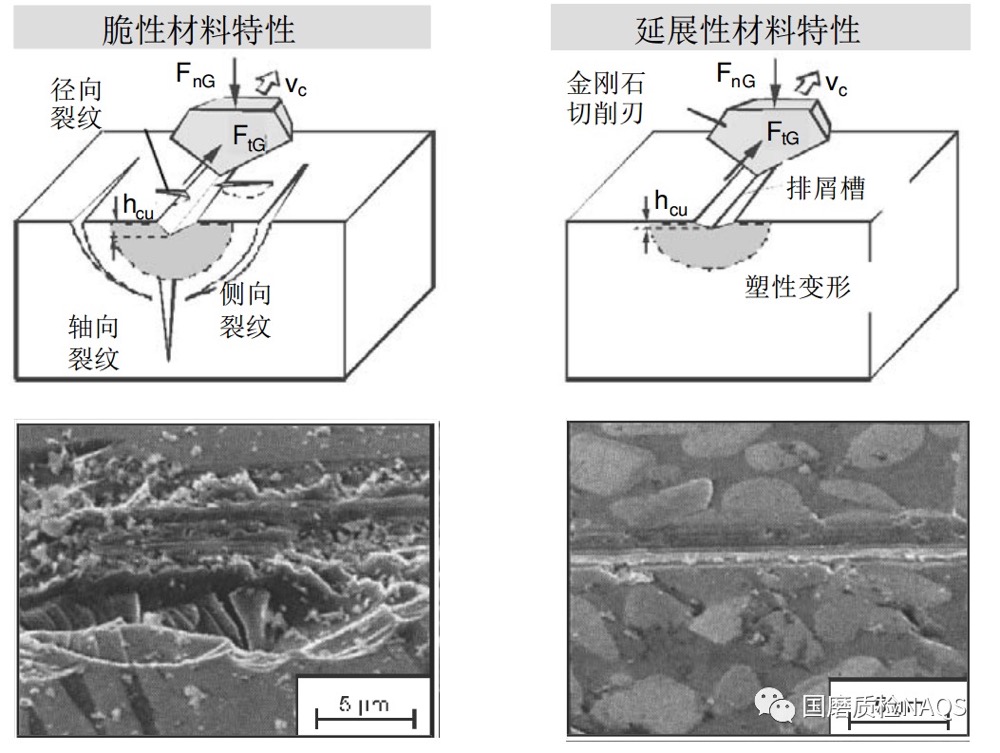
圖 2 脆性材料上的材料分離和裂紋形成
2 高性能陶瓷的磨削
陶瓷的種類及其特性
根據(jù)材料特性,陶瓷可分為氧化物陶瓷、非氧化物陶瓷和硅酸鹽陶瓷。氧化物陶瓷中,氧化鋁和氧化鋯(ZrO2)是工業(yè)上最重要的材料,具有良好的燒結(jié)性能,但耐熱性不如其他類型陶瓷。非氧化物陶瓷主要包括碳化物(碳化硼B(yǎng)4C、碳化硅SiC)、氮化物(氮化硅Si3N4)、硼化物和硅化物,它們具有高共價鍵比例(5-40%),結(jié)合小原子間距離,使其具有高化學和熱穩(wěn)定性,帶來高強度和硬度,但也限制了其延展性。硅酸鹽陶瓷又分為粗陶瓷和細陶瓷,粗陶瓷包括鎂質(zhì)陶瓷、莫來石、石英或鋯石。細陶瓷包括玻璃陶瓷、滑石和堇青石。
陶瓷磨削與金屬磨削的差異
與金屬加工相比,陶瓷加工通常需要更高的加工力,尤其在垂直方向。堅固的機器和主軸系統(tǒng)是吸收這些力道的重要因素,否則過軟的系統(tǒng)會導致功能表面尺寸和形狀精度下降。此外,陶瓷加工對機器的保護要求更高,因為研磨過程中產(chǎn)生的磨料具有很強的磨蝕性。
陶瓷磨削的工具和工藝
許多研究探討了金剛石磨輪在陶瓷磨削中的應(yīng)用。由于金剛石對強熱負荷敏感,冷卻潤滑劑的供應(yīng)變得更加重要。就結(jié)合類型而言,陶瓷磨削中 使用樹脂和金屬結(jié)合的工具。樹脂結(jié)合磨輪雖然磨損更大,但加工力更低,通常能獲得更好的表面質(zhì)量和形狀精度。金剛石顆粒尺寸通常在D7到D252之間,大多數(shù)加工操作使用D91到D181之間的顆粒。陶瓷加工中的金剛石濃度通常在C75到C100之間 。
陶瓷磨削的加工速度和精度
對于外圓磨削,據(jù)報道,高性能陶瓷的最高特定材料去除率可達50 mm3/mms。其他磨削方式,例如平面磨削,可以實現(xiàn)更高的去除率,但并非典型方法。在陶瓷切屑去除過程中,提高加工性能會同時導致加工力增加。
3 玻璃加工
氧化物玻璃中,共價鍵和離子鍵占主導地位。它們通常表現(xiàn)出強極化,這也是其特征性脆裂去除行為的原因。如果材料移動導致這些鍵斷裂,玻璃的結(jié)構(gòu)將無法修復,而金屬的自由電子可以形成新的鍵。
圖 3 展示了當磨料切削刃穿透玻璃時,隨著切屑厚度增加,玻璃的材料行為示意圖。在超過臨界切屑厚度,即引發(fā)微裂紋之前,即使玻璃為非晶結(jié)構(gòu),也仍可對其進行類似于延性加工的處理。通過這種加工方式,玻璃也可以得到無損傷的外表面。
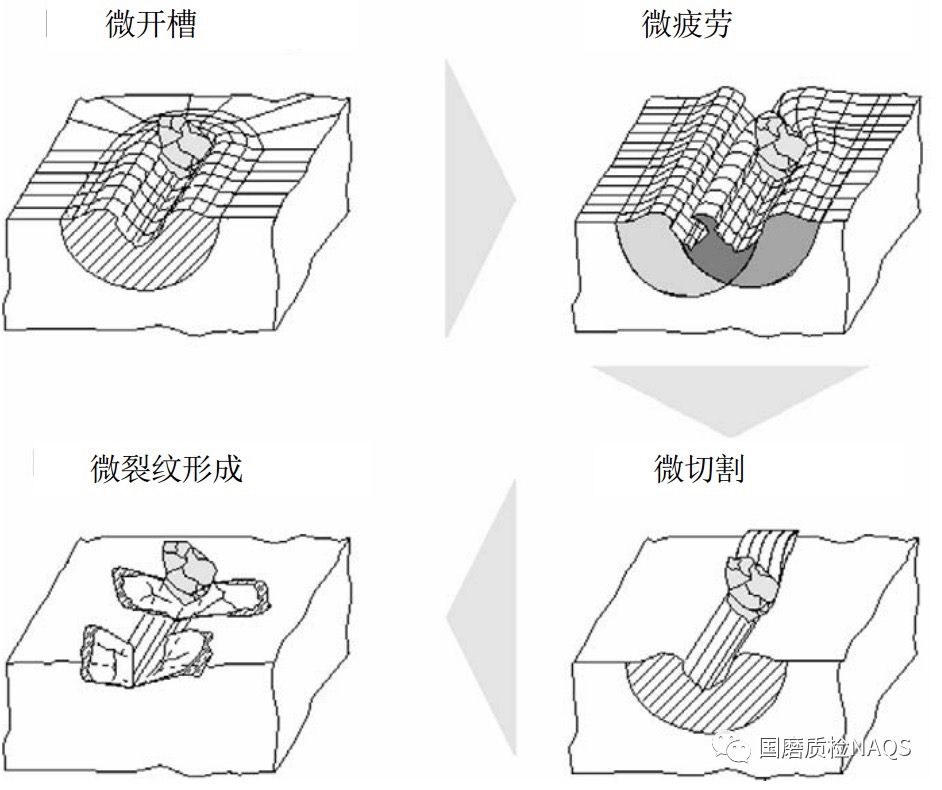
圖3 磨粒與玻璃嚙合時可能的移除機制
據(jù)推測,為了實現(xiàn)延性材料去除并獲得靜水壓縮應(yīng)力狀態(tài),需要采用非常負的前刀角。除此之外,還有幾種方法可以幫助減小單個切屑厚度:
? 使用更小的粒度
? 更高的磨粒濃度
? 低進給率
? 低切深
? 高切削速度(只要避免熱損傷)
? 砂輪高徑向精度(需要使用超精密磨床)
? 均勻的輪廓(無裸露磨粒)
4 硅
單晶硅憑借其優(yōu)異的物理化學特性、相對低廉的價格和近乎無限的可用性,在微電子半導體元件制造中扮演著基礎(chǔ)材料的主角。
硅晶體呈鉆石晶格結(jié)構(gòu),可以用兩個相互穿插的面心立方基本單元描述,它們在每個方向上都偏移了四分之一的邊長距離。
單晶硅的機械性能受其各向異性鍵合力影響。例如,對于彈性模量,[100]、[010] 和 [111] 晶向的 E 值分別為 130.2 GPa、168.9 GPa 和 187.5 GPa。
鉆石晶格中硅的共價鍵由于價電子嚴格局域化而高度穩(wěn)定,因此這種材料非常堅硬且脆。室溫拉伸試驗達到的變形特征值表明,硅在很大程度上表現(xiàn)出理想/彈性行為,即總膨脹量很小。從宏觀角度來看,斷裂應(yīng)力會在沒有明顯塑性變形的情況下直接導致原子鍵斷裂和晶格破壞(脆性斷裂)。
高溫研究表明,存在一定溫度范圍,硅呈現(xiàn)塑性材料行為。脆性和韌性行為之間的轉(zhuǎn)變溫度數(shù)據(jù)在 400 到 1000°C 之間波動。在位錯密度較高的情況下,從脆性到韌性材料行為的轉(zhuǎn)變會向更低的溫度方向移動。然而,即使在室溫下,在強烈的應(yīng)力下,也可以在靠近表面的晶體區(qū)域觀察到變形 。
硅主要用作晶片材料。晶片從硅單晶(錠)中分離,并在平面表面進行切屑去除。磨削分離后的晶片,通常采用包括預處理和后處理兩個步驟的二步法。首先進行粗磨,目的是去除分離后表面狀況非常差的晶片表面,并磨平凹槽。為此,通常選擇相對較粗的磨粒(合成樹脂或陶瓷結(jié)合劑中的 D46),以實現(xiàn)高材料去除率 (Qw = 100 至 200 mm3/s)。在這種情況下,如果外部區(qū)域的損傷深度小于后續(xù)精磨工藝的切深,脆性加工機制是可以接受的。精磨的最新技術(shù)是合成樹脂結(jié)合的 D6 磨粒。合成樹脂結(jié)合劑優(yōu)于玻璃化結(jié)合劑。精磨時,通常選擇 Qw = 5 到 15 mm3/s 的低材料去除率。通過這種方式利用韌性加工機制,可以實現(xiàn) Ra < 10 nm 的表面質(zhì)量和小于 3 μm 的外部區(qū)域損傷,從而降低后續(xù)處理成本 。


 手機資訊
手機資訊 官方微信
官方微信








 豫公網(wǎng)安備41019702003604號
豫公網(wǎng)安備41019702003604號